성능 및 효율성 향상을 위해 전력 설계에 3세대 SiC MOSFET을 적용하는 방법
DigiKey 북미 편집자 제공
2022-11-02
산업용 모터 구동기, AC/DC 및 DC/DC 인버터/컨버터, 배터리 충전기, 에너지 저장 시스템 등 전력 응용 제품 전반에서 효율성 향상, 소형화, 성능 향상을 위한 끊임없는 노력이 있습니다. 이러한 공격적인 성능 요구 사항은 실리콘(Si) MOSFET의 기능을 능가하고 실리콘 카바이드(SiC) 기반의 최신 트랜지스터 아키텍처로 이어졌습니다.
이러한 최신 장치는 주요 성능 지표에서 큰 이점을 제공했지만 설계자는 다양한 제한과 응용 불확실성으로 인해 1세대 SiC 장치를 경계하는 것이 현명했습니다. 2세대 장치는 장치에 대한 세부적이고 정확한 이해와 함께 향상된 사양을 제공했습니다. SiC MOSFET 성능이 향상되고 출시 시간 압력이 증가하면서 설계자는 제품 목표를 달성하기 위해 이러한 최신 장치를 사용했습니다. 최근에는 3세대 장치가 SiC 기반 전력 장치의 완성도를 입증하고 있습니다. 이러한 장치는 이전 세대의 설계 경험과 관련 전문성을 기반으로 하면서 주요 파라미터를 개선합니다.
이 기사에서는 Si와 SiC를 비교한 후 3세대 SiC MOSFET 개발 및 마이그레이션에 대해 살펴봅니다. 그런 다음 이러한 장치가 설계자가 전력 시스템 설계에서 중요한 발전을 이루는 데 얼마나 도움이 되는지를 보여주는 Toshiba Semiconductor and Storage Corp.(Toshiba)의 실제 사례를 소개합니다.
실리콘과 SiC의 비교
지난 수십 년에 걸쳐 실리콘 기반 MOSFET은 기본 공급 장치 및 인버터부터 모터 구동기까지 광범위한 전력 시스템 설계를 혁신해 왔습니다. 기능적으로 유사하지만 구조와 특성이 매우 다른 반도체인 절연 게이트 양극 트랜지스터(IGBT)와 함께 스위칭에 최적화된 Si MOSFET을 사용하면서 선형 토폴로지를 기반으로 하는 기존의 비효율적인 전력 변환 및 관리에서 스위칭된 제어를 사용하는 훨씬 효율적이고 콤팩트한 방식으로 전환할 수 있게 되었습니다.
대부분의 설계에서는 펄스 폭 변조(PWM)를 사용하여 폐쇄 루프 피드백 배열에서 원하는 전압, 전류 또는 전력 값을 제공하고 유지합니다. 실리콘 MOSFET의 사용이 증가하면서 요구도 함께 증가했습니다. 또한 새로운 효율성 목표(대부분 규제에 따름), 전기 자동차 및 스마터 모터 제어기 시장, 재생 에너지 및 관련 에너지 저장 시스템을 위한 전력 변환 등으로 인해 이러한 MOSFET의 기능적 효율적 향상이 촉진되었습니다.
그 결과 상당한 R&D 노력에 힘입어 실리콘 기반 MOSFET의 성능이 향상되었지만, 연구자들은 이러한 노력이 효용체감점에 도달하고 있다는 것을 깨달았습니다. 다행히, 이론적으로는 실리콘을 단독으로 사용하는 대신 SiC를 기질로 사용하는 전력 스위칭 장치에 기반하는 대안이 있었습니다.
SiC를 사용하는 이유
다양한 물리학적 이유로 인해 SiC는 실리콘과 크게 차별화되는 세 가지 주요 전기적 특성을 가지며, 각 특성은 작동상의 장점을 제공합니다. 이외에 미묘한 다른 차이점도 있습니다(그림 1).
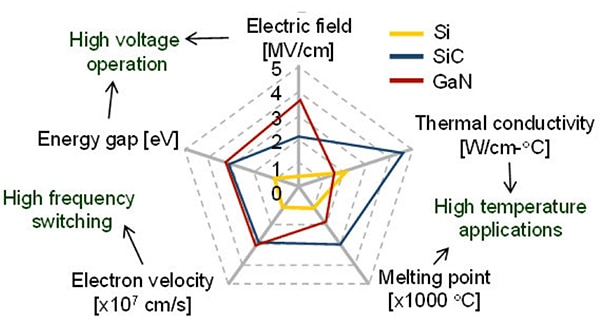 그림 1: SiC와 Si 및 질화 갈륨(GaN) 고체 소재 간의 대략적인 주요 소재 속성 비교 (이미지 출처: Researchgate)
그림 1: SiC와 Si 및 질화 갈륨(GaN) 고체 소재 간의 대략적인 주요 소재 속성 비교 (이미지 출처: Researchgate)
세 가지 주요 특성은 다음과 같습니다.
- 높은 임계 항복 전기장 전압(0.3MV/cm에 비해 약 2.8MV/cm 높음) - 드레인 소스 '온스테이트' 저항(RDS(on))이 크게 감소하여 훨씬 얇은 레이어에서 지정된 정격 전압으로 작동할 수 있습니다.
- 높은 열 전도율 - 단면적당 더 높은 전류 밀도를 지원합니다.
- 폭넓은 밴드갭(반도체 및 절연체의 가전자대 상단과 전도대 하단 사이의 에너지 차이(eV)) - 높은 온도에서 누설 전류가 감소됩니다. 따라서 SiC 다이오드와 전계 효과 트랜지스터(FET)를 와이드 밴드갭(WBG) 장치라고도 합니다.
결과적으로 SiC 기반 장치는 실리콘 단독 구조보다 최대 10배 더 높은 전압을 차단할 수 있으며, 동일한 다이 영역을 활용하면서 25°C에서 RDS(on)이 절반 이하에 불과합니다(모든 수치는 근사값임). 또한 유해한 테일 전류가 없으므로 SiC 장치의 끄기 스위칭 관련 손실이 적습니다. 동시에 125°C에 비해 훨씬 더 높은 약 200°C의 온도에서도 작동할 수 있으므로 열 설계 및 관리 문제가 완화됩니다.
성능 특성과 발전으로 인해 SiC 장치는 IGBT, 실리콘 MOSFET 및 GaN 장치를 결합한 전력 및 속도 비교 응용 매트릭스에서 이제 중요한 위치를 차지하고 있습니다(그림 2).
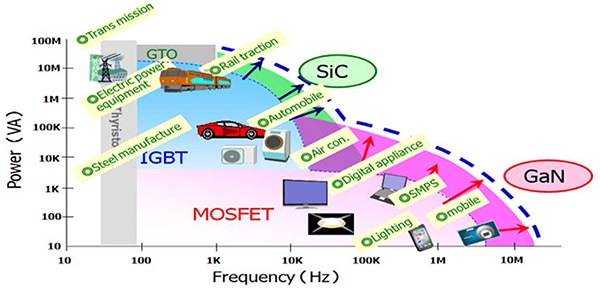 그림 2: SiC MOSFET은 성능 특성으로 인해 전력 및 주파수 정격을 포함하는 광범위한 응용 분야에 적합합니다. (이미지 출처: Toshiba)
그림 2: SiC MOSFET은 성능 특성으로 인해 전력 및 주파수 정격을 포함하는 광범위한 응용 분야에 적합합니다. (이미지 출처: Toshiba)
기본 SiC 소재 과학 및 장치 물리학에서 상업용 SiC MOSFET으로의 전환은 빠르지도 쉽지도 않았습니다(그림 3). 포괄적인 연구와 생산 노력으로 첫 번째 SiC 기반 장치인 쇼트키 다이오드가 2001년에 도입되었습니다. 그후 20년 동안 업계에서는 1세대, 2세대, 3세대 SiC MOSFET을 개발하고 생산량을 출시했습니다. 각 세대는 다소 다른 트레이드 오프와 함께 특정 파라미터에서 목표한 개선을 이루었습니다.
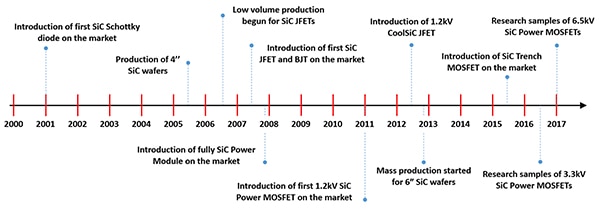 그림 3: 상업용 SiC 기반 장치의 역사는 2001년에 등장한 1세대 상업용 SiC 쇼트키 다이오드에서 시작됩니다. (이미지 출처: IEEE Transactions on Industrial Electronics, 2017)
그림 3: 상업용 SiC 기반 장치의 역사는 2001년에 등장한 1세대 상업용 SiC 쇼트키 다이오드에서 시작됩니다. (이미지 출처: IEEE Transactions on Industrial Electronics, 2017)
용어를 명확히 해야 합니다. 이전 세대 실리콘 전용 제품과 마찬가지로 SiC 기반 FET은 MOSFET입니다. 넓은 의미에서 물리적인 내부 구조는 비슷하며, 두 장치 모두 소스, 드레인, 게이트 연결을 포함하는 3단자 장치입니다. 차이점은 이름에 나타난 그대로입니다. 즉, SiC 기반 FET은 실리콘만 사용하는 것이 아니라 기본 소재로 SiC를 사용합니다.
1세대 및 2세대부터 시작
스위칭 장치의 성능을 특정하는 많은 파라미터가 있습니다. 많은 정적 파라미터 중에는 주어진 다이 크기와 패키지에 대한 전력 처리 기능과 관련 있는 두 정적 성능 지수, 즉 RDS(on) 및 최대 작동 온도와 함께 최대 작동 전압, 최대 전류 정격 등이 있습니다.
또한 스위칭 장치로서 동적 파라미터는 스위칭 손실을 평가하는 데 필요하므로 중요합니다. 주로 언급되는 동적 FoM은 RDS(on) 및 게이트 전하의 곱이며(RDS(on) × Qg), 역회복 전하 Qrr이 점점 더 중요해지고 있습니다. 오버슈트, 링잉 또는 기타 왜곡 없이 전류를 스위칭 장치에 적절히 공급하고 싱크하는 데 필요한 게이트 구동기의 크기와 기능은 주로 FoM에 의해 결정됩니다.
1세대 SiC 장치의 사용 및 시장 성장은 신뢰성 문제로 인해 억제되었습니다. 그중 하나로 전력 MOSFET의 전원과 드레인 사이에 배치되는 PN 다이오드가 있습니다. PN 다이오드에 인가된 전압이 전원을 인가하여 온스테이트 저항이 변경되어 장치 신뢰성이 저하됩니다.
Toshiba의 2세대는 MOSFET에 포함된 쇼트키 장벽 다이오드(SBD)를 사용하여 기본 SiC 장치 구조를 수정함으로써 이 문제를 대부분 해결했습니다(그림 4). 그 결과 신뢰성이 10배 이상 향상되었습니다. 새로운 구조에서는 SBD를 셀 내부의 PN 다이오드와 병렬로 배치하여 PN 다이오드의 전원 공급을 방지했습니다. 온스테이트 전압이 PN 다이오드보다 낮기 때문에 내장형 SBD를 통해 전류가 흘러 온스테이트 저항의 일부 변화와 MOSFET 신뢰성 저하를 억제합니다.
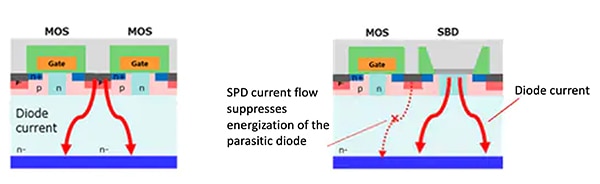 그림 4: 내부 쇼트키 장벽 다이오드(BSD)가 없는 SiC MOSFET(왼쪽)과 달리 BSD가 있는 SiC MOSFET(오른쪽)은 기생 PN 다이오드의 전원 공급을 최소화할 수 있습니다. (이미지 출처: Toshiba)
그림 4: 내부 쇼트키 장벽 다이오드(BSD)가 없는 SiC MOSFET(왼쪽)과 달리 BSD가 있는 SiC MOSFET(오른쪽)은 기생 PN 다이오드의 전원 공급을 최소화할 수 있습니다. (이미지 출처: Toshiba)
내장형 BSD는 온스테이트 저항을 고전압 제품에서만 허용되는 수준으로 높이므로 BSD가 내장된 MOSFET은 이미 실사용되고 있지만 3.3kV 장치와 같은 고전압 제품에서만 사용됩니다. Toshiba는 다양한 장치 매개 변수를 조정하여 MOSFET의 SBD 면적 비율이 온스테이트 저항이 증가하는 것을 억제하는 데 중요한 역할을 한다는 사실을 발견했습니다. SBD 비율을 최적화하여 Toshiba는 신뢰성이 현저하게 개선된 1.2kV 클래스 SiC MOSFET을 고안했습니다.
하지만 대부분의 개선 사항과 마찬가지로 트레이드 오프가 있습니다. 새로운 장치 구조는 신뢰성을 크게 개선했지만 두 FoM에 유해한 영향을 주기도 했습니다. 공칭 RDS(on)과 RDS(on) × Qg를 높여서 MOSFET의 성능이 저하되었습니다. 온스테이트 저항을 보정하여 줄이기 위해 2세대 SiC MOSFET에서는 다이 영역을 늘렸지만 그로 인해 비용이 증가했습니다.
실질적인 완성도를 보여주는 3세대
이러한 우려를 의식해서 Toshiba는 TWXXXN65C/TWXXXN120C 제품군이라는 3세대 SiC MOSFET 장치를 개발했습니다. 이 장치는 전류 확산층의 구조를 최적화하여 셀 크기를 줄이는 동시에 정격 전압과 스위칭 속도를 높이고 온스테이트 저항을 줄였습니다.
확산 저항(Rspread)을 줄여서 온스테이트 저항을 일부 낮췄습니다. SiC MOSFET의 P형 확산 영역(P-well) 아래쪽에 질소를 주입하여 SBD 전류를 높였습니다. 또한 Toshiba는 JFET 영역을 줄이고 질소를 주입하여 피드백 정전 용량과 JFET 저항을 줄였습니다. 그 결과 온스테이트 저항의 증가 없이 피드백 정전 용량이 감소되었습니다. 또한 SBD 배치를 최적화하여 온스테이트 저항의 변동 없이 안정적인 작동을 실현했습니다.
현재 이 제품군은 400V 및 800V AC/DC 전원 공급 장치, 광발전(PV) 인버터, 무정전 전원 공급 장치(UPS)용 양방향 DC/DC 컨버터와 같은 고전력 산업용 응용 제품을 위해 고안된 650V 및 1200V SiC MOSFET으로 구성됩니다. 650V SiC MOSFET과 1,200V SiC MOSFET은 모두 업계 표준 3리드 TO-247 패키지(그림 5)로 제공됩니다.
 그림 5: 표준 T0-247 패키지로 제공되는 Toshiba 650V 및 1200V 3세대 SiC MOSFET은 광범위한 전력 변환, 제어 및 관리 응용 제품에 적합합니다. (이미지 출처: Toshiba)
그림 5: 표준 T0-247 패키지로 제공되는 Toshiba 650V 및 1200V 3세대 SiC MOSFET은 광범위한 전력 변환, 제어 및 관리 응용 제품에 적합합니다. (이미지 출처: Toshiba)
이 3세대 SiC MOSFET에서는 RDS(on) × Qg FoM이 Toshiba의 2세대 장치에 비해 80% 감소되고(현저한 감소) 스위칭 손실이 약 20% 줄었습니다. 또한 내장된 쇼트키 장벽 다이오드 기술이 순방향 초저전압(VF)을 제공합니다.
MOSFET과 관련된 다른 설계상 세부 사항이 있습니다. VGSS를 예로 들어 보겠습니다. VGSS는 드레인과 소스가 단락된 상태에서 게이트와 소스 간에 인가될 수 있는 최대 전압입니다. 3세대 SiC 장치의 VGSS 범위는 10V ~ 25V이고, 권장 전압은 18V입니다. 폭넓은 VGSS 정격으로 설계가 간소화되고 설계 신뢰성이 향상됩니다.
또한 낮은 저항과 높은 게이트 임계 전압(VGS(th))(MOSFET 채널에서 전도가 시작되는 전압)는 스파이크, 결함, 오버슈트 등으로 인한 우발적 전원 켜짐과 같은 오작동을 방지합니다. 이 전압 범위는 3.0V ~ 5.0V로서, 게이트 구동기 설계를 간소화하면서 최소 드리프트로 예측 가능한 스위칭 성능을 보장하는 데 도움이 됩니다.
650V 및 1200V 3세대 SiC MOSFET에 대해 자세히 알아보기
제품군 스펙트럼의 양쪽 끝에 있는 650V 장치와 1200V 장치는 해당 기능의 범위를 나타냅니다. 두 제품의 물리적 패키지, 핀아웃 및 회로도 기호는 동일하지만(그림 6), 구체적인 사양은 다릅니다.
 그림 6: Toshiba의 모든 3세대 SiC MOSFET 제품군은 물리적 배열과 회로도 기호가 동일합니다. 기호에서 내장형 쇼트키 장벽 다이오드에 유의하십시오. (이미지 출처: Toshiba)
그림 6: Toshiba의 모든 3세대 SiC MOSFET 제품군은 물리적 배열과 회로도 기호가 동일합니다. 기호에서 내장형 쇼트키 장벽 다이오드에 유의하십시오. (이미지 출처: Toshiba)
650V 장치에는 100A, 342W 정격 N 채널 장치인 TW015N65C가 있습니다. 이 장치의 일반적인 사양 값은 4,850pF의 입력 정전 용량(CISS), 128nC의 낮은 게이트 입력 전하(Qg), 15mΩ에 불과한 공칭 RDS(on)입니다.
정적 파라미터와 동적 파라미터의 최소, 일반, 최대 수치 표와 함께 규격서에는 온도, 드레인 전류, 게이트 소스 전압(VGS) 등과 같은 중요 파라미터 및 요소의 성능을 비교해서 보여주는 그래프가 포함되어 있습니다. 예를 들어 그림 7은 RDS(on) 값과 온도, 드레인 전류(ID) 및 게이트 소스 전압 VGS를 비교해서 보여줍니다.
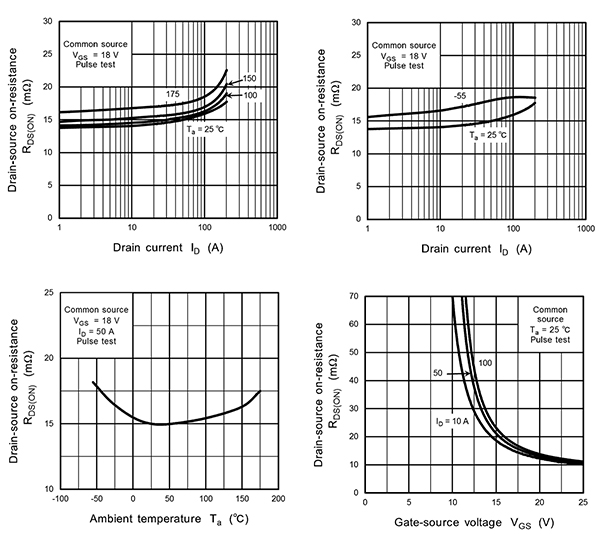 그림 7: TWO15N65C의 온스테이트 저항을 드레인 전류, 주위 온도, VGS 등 다양한 측면에서 특정하는 그래프를 보여줍니다. (이미지 출처: Toshiba)
그림 7: TWO15N65C의 온스테이트 저항을 드레인 전류, 주위 온도, VGS 등 다양한 측면에서 특정하는 그래프를 보여줍니다. (이미지 출처: Toshiba)
그림 8에서는 TW140N120C(20A, 107W, N 채널 장치)와 같은 1200V 장치에 대해 동일한 사양 및 그래프를 보여줍니다. 이 SiC MOSFET은 6000pF의 낮은 CISS, 158nC의 게이트 입력 전하(Qg), 140mΩ의 RDS(on)을 제공합니다.
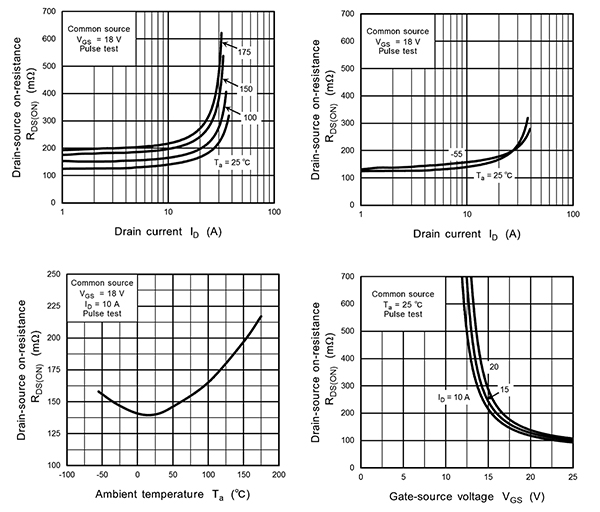 그림 8: TW140N120C에 대한 온스테이트 저항 특성화 그래프 (이미지 출처: Toshiba)
그림 8: TW140N120C에 대한 온스테이트 저항 특성화 그래프 (이미지 출처: Toshiba)
10개의 3세대 Toshiba SiC MOSFET은 5개의 650V 장치 및 5개의 1200V 장치로 구성됩니다. 25°C에서 온스테이트 저항, 전류 및 전력 정격은 다음과 같습니다.
650V:
- 15mΩ, 100A, 342W(TWO15N65C)
- 27mΩ, 58A, 156W
- 48mΩ, 40A, 132W
- 83mΩ, 30A, 111W
- 107mΩ, 20A, 70W
1200V:
- 15mΩ, 100A, 431W
- 30mΩ, 60A, 249W
- 45mΩ, 40A, 182W
- 60mΩ, 36A, 170W
- 140mΩ, 20A, 107W(TW140N120C)
결론
실리콘 카바이드 MOSFET은 실리콘 전용 장치에 비해 중요 스위칭 파라미터를 크게 개선했습니다. 이전 세대에 비해 3세대 SiC 부품은 사양, FoM, 신뢰성 및 게이트 구동기 요구 사항 특성화를 개선하고, 불가피한 설계 세부 사항에 대한 향상된 통찰력을 제공합니다. 이러한 SiC MOSFET을 사용하여 전력 시스템 설계자는 효율성 향상, 소형화, 전반적인 성능 향상을 위해 사용할 수 있는 추가 핵심 리소스를 확보했습니다.

면책 조항: 이 웹 사이트에서 여러 작성자 및/또는 포럼 참가자가 명시한 의견, 생각 및 견해는 DigiKey의 의견, 생각 및 견해 또는 DigiKey의 공식 정책과 관련이 없습니다.







